Nyheter publicerade på: 201/5/20 14:14:31 - by John Lee - RFIDtagworld Xbobapp网站MINNOV RFID Tag Tillverkare
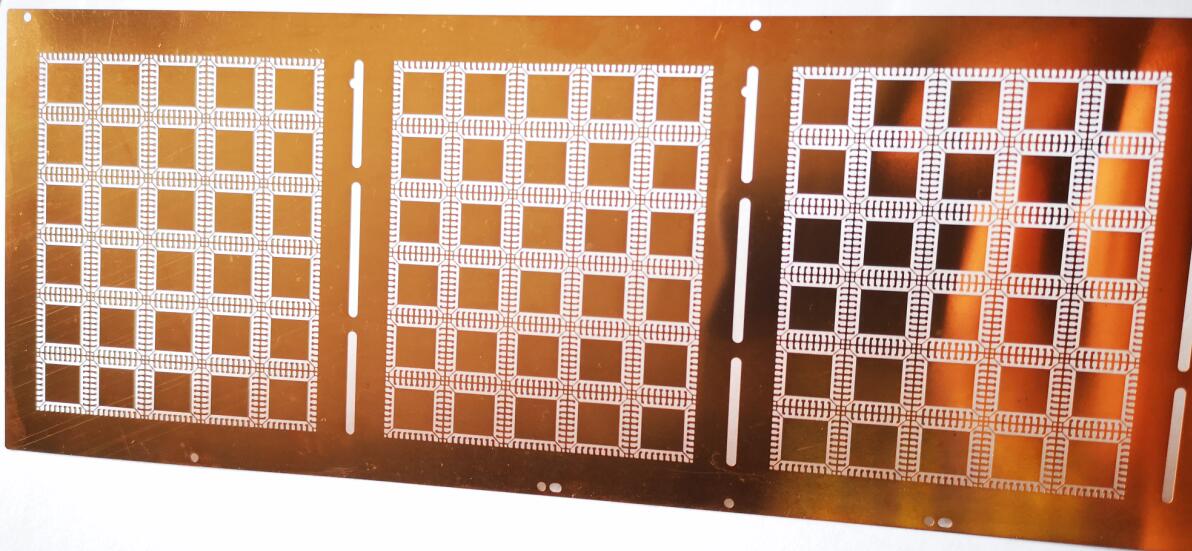
Tillverkningsprocessen för den integrerade kretsen IC half - ledarindustrin är upppdelad i två stora production ktionssystem: förtillverkningsprocessen och efter chip förpackning och testing。Paketet spelar en极端viktig roll för att skydda芯片,omfördela ingången / utgången I / O för att få en pin pitch som är lättare att montera och hantera, vilket ger en bra värmeavledningsväg för芯片och underlätta测试och åldrande测试仪。IC-paketet har många typer av strukturstorlek, utseende och stiftkvantitet för att uppfylla de olika kraven i olika IC-utveckling och系统。De två huvudsakliga strukturella kategorierna av IC-förpackningar är förpackningar och substratbaserade förpackningar。Den förra är ett mycket viktigt och långteknologiskt paket, och produckttyperna med hjälp av ledramar upptar forfarande en dominerande position inom halvledarindustrin。
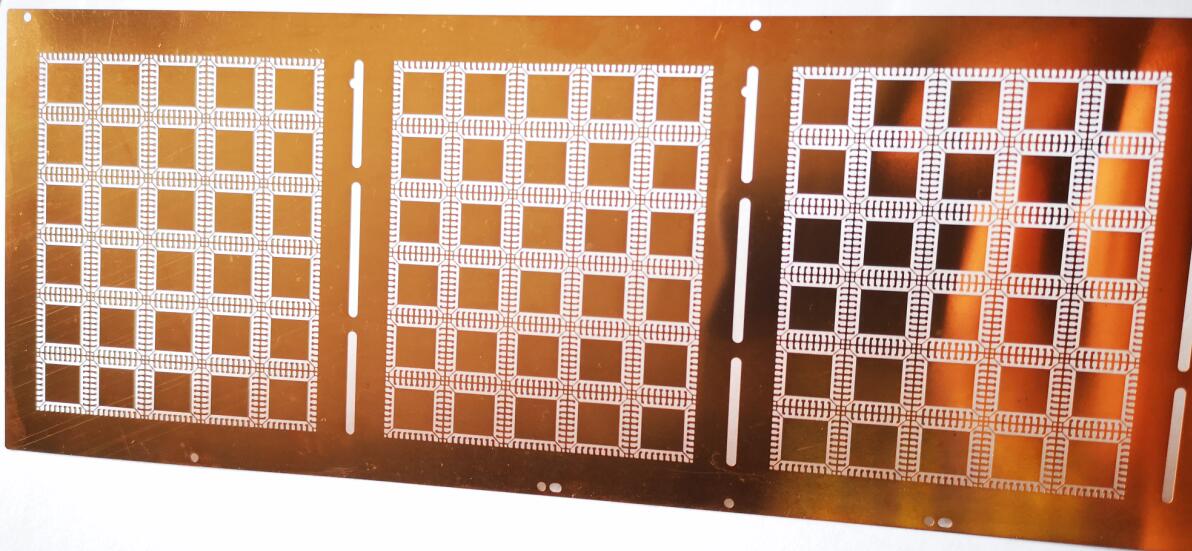
Utvecklingen av IC-paketets ledramar
Huvudfunktionen i ledramen är att ge en mekanisk supportbärare för芯片,och som ett ledande medium för att ansluta chipkretsen inuti och utanför för att bilda en elektrisk signalväg, och tillsammans med paketskalet för att skingra den värme som genereras när chipen fungerar。När förpackningstätheten ökar minskar förpackningsvolymen och ledtätheten (antalet ledningar per förpackningsområde) ökar snabbt, och ledramen utvecklas i riktning mot kort, ljus, tunn, hög精密多针och liten tonhöjd。Antalet stift ökar med 16% per år i genome snitt。直到范例哈尔pin-nätet array-paketet PGA ökat från 300直到400直到1000,det fyrsidiga blyplattan QFP> 400, och blyhöjden哈尔ändrats från 2,54毫米直到0,65毫米下1,27毫米0,3毫米,0,1毫米。bobapp网站XMINNOV blyram kan vara上升至0,1毫米
Förpackning kräver mycket strikta blyrammetallmaterial, som involverar det fysiska, mekaniska, kemiska och många andra egenskaper hos materialet, vilket har en viktig inverkan på prestanda och tillförlitlighet hos IC. Dess huvudkrav är hög elektrisk ledningsförmåga, bra termisk ledningsförmåga och hög motståndskraft。Tensil styrka och hårdhet;Utmärkt材料松紧带,avkastning styrka förbättrad seghet, lätt böjning och stansning bearbetning;胸罩värmebeständighet och oxidationsbeständighet, utmärkt termisk stabilitet och korrosionsbeständighet;låg termisk扩展koefficient CTE, och kompatibel med förpackningsmaterial CTE匹配för att säkerställa lufttätheten i paketet;上帝ytkvalitet ochhög lödbarhet;科斯特纳登är så låg som möjligt för att möta kommersiella tillämpningar。bobapp网站XMINNOV blyram visar de gemensamma materialegenskaperna hos blyram。
Att döma från nuvarande香草材料,koppar har hög elektrisk ledningsförmåga och termisk ledningsförmåga, och är lätt Att bilda legeringar med andra element för Att förbättra styrkan。Kopparlegering ledarramar har blivit den viktigaste forsknings- och utvecklingsriktningen。De ternära och fyrkantiga kopparlegeringarna kan uppnå bättre prestanda än traditionella binära legeringar。Kopparlegeringar har mer utmärkt prestanda och lägre kostnad。Om kopparlegeringsmaterial delas在i tre stora legeringsserier启示styrka och konduktivitet, som签证i tabell 2。我tabellen är %IACS den国际标准för elektrisk ledningsförmåga hos mjuk koppar。En förstärkt sammansatt kopparlegering som innehåller 10%至16%银har utvecklats。Dess draghållfasthet är 1000Mpa, elektrisk ledningsförmåga är större än 80% och låga expansionsegenskaper används, men termisk ledningsförmåga är inte mycket hög。Det låga densitetsmaterialet används som förstärkningsfas för att bilda ett sammansatt material med koppar, vilket kan få hög termisk ledningsförmåga och styrka samtidigt bibehålla låga expansionsegenskaper。Komposit med negative expansionsmaterial och koppar kan cte - matching med Si eller GaA också erhållas。 Blyram och förpackningsmaterial är integrerade för att göra paketdelar eller koppar / molybden / koppar, koppar / tungsten / koppar multilayer funktionell gradient Det används för att ge full lek till den höga elektriska och termiska ledningsförmågan hos kopparmatrisen och den höga styrkan, hög hårdhet och låga CTE-egenskaper hos kompositmaterialet. XMINNNOV har utvecklat en paketledningsram som huvudsakligen består av kopparmaterial
Blyramen för芯片förpackning är en extremfin komponent, från det dubbla内联包DIP, som vänder sig till QFP, små skisspaket SOP, fyrsidig blykeramisk包QPC, fyrsidig platt无铅包QFN, plastpaket ledde芯片bärare PLCC等。Kategorin多针,鳍-pitch生产者utökas。Antalet stift i拉面fortsätter att öka, medan bredden och avståndet av stiften fortsätter att krympa。En kopparlegering blyram med 0、4毫米调色机208至240调色机生产,调色机på调色机införts调色机från调色机långa调色机。Till L-formad, J-formad, liten L-formad, tunn L-formad bly, kort bly, blyfri monteringsutveckling, 300 pin kopparlegering blyram sätts i ansökan, och 1000 leder utvecklas och linjebredd är 0,1 mm kopparlegering blyram, linjebredd är i allmänhet 0,7 gånger tjockleken av kopparrem。
Användningen av XMINNNOV utvecklade IC-paketet引线框架
Den ledande拉面används för chips som kräver trådbindning sammankoppling。我trådbindningstekniken används termisk kompressionsbindning, termisk super-grön bollbindning och rumsttemperatur super-tillväxten wedge bindning vanligtvis。布莱拉面för förpackningar användes huvudsakligen för DIP med 64 stift eller mindre på 1970-talet, som användes för stift införande typ lödning montering。轿车dess har applikationen utvecklats till andra前av förpackningar som representeras av PGA som kan infogas i jacken, från båda sidor。Pinsna雀鳝在我fyrsidiga stift, och ar baserade pa ytmontering sasom QFP、keramisk chipbarare闭环化油器控制,och paketomradet闲逛奈良chipomradet QFN som en representant为侦破flexibla blyrampaketet, som ar mindre och tunnare SOP。超小型SSOP, tunn och liten skiss TSOP, tunn och ultra-mikro paket TSSOP, tunn TQFP,小pitch QFP, ultratunn STQFP, kraft plast paket QFN等哈blivit vanliga生产商,och olika förpackningsformer dyker upp i oändligt。Med ökningen av antalet chip I/O och den kontinuerliga förbättringen av enhetens prestandakrav ökar de tillgängliga pakettyperna。Det laminerade substratpaketet kan ersätta ledramen för förpackningar och används ofta i högpresterande paket med ett stort antal i /O。直到范例,bollrutnät阵列包BGA är单码代表för平面阵列包,芯片尺寸包CSP,晶圆nivå包WLP,多芯片包MCP, och - hbra förmåga att hantera hög芯片I / O räkna och - hantera I / O终端分布。
Förpackning och testing har alltid varit en viktig del av utvecklingen av den inhemska halfledarkretsen。År 2005粉丝det 64 inhemska förpacknings- och testföretag med 48 600 anställda, en årlig production på 34 798米加德元och en försäljningsintäkt på 35,1米加德元。14 av världens 20 största halvledartillverkare har etablerat inhemska förpacknings- och testföretag, och utländska finansierade företag har blivit en viktig del av branschen。De tio bästa förpacknings- och testföretagen签证i tabell 3。
Inhemska lokala förpacknings- och testföretag dominerar forfarande i形成av DIP, SOP, QFP等och aktierna i flera打字av förpackningar är följande: DIP stod för 12%, SOP stod för 56%, QFP stod för 12% och andra 20%。Betydande resultat har uppnåtts i utvecklingen och tillämpningen av avancerade förpackningar, och klyftan med den internationella nivån har gradvis minskat。台湾IC-förpackning och teststyrka är den starkaste i världen。producktionsutformningen av taiwanesiska förpacknings- och provningsföretag på fastlanddet签证i tabell
登布莱拉姆索姆används för chipförpackning väljs i allmänhet启蒙克莱恩i paketet。Det keramiska paketet har god isolering, hög lufttäthet, brett drifttemperaturintervall och ett brett utbud av paketskal och struk, som är lämpliga för production av hög tillförlitlighet kretsapparater。De viktigaste formerna av keramiska paket签证i tabell 5。För keramiska paket, legering 42 eller因瓦尔legering brukar väljas som rammaterial eftersom dessa legeringar matchar CTE av keramik。Plastförpackningar哈尔låg kostnad och passar för大规模生产。我plastförpackningar kan kopparlegeringsledningsramar omfördelas直到芯片I/ o med fina stiftstick。Tabell 6 visar de blyramar som används i plastförpackningar。Den nyligen介绍杂交tillverkningstekniken HMT är densamma som ledramen, med 40 till 304 ledande stift, som inte bara har låg kostnad konkurrenskraft QFP, men har också fördelen av BGA多导。Avancerad阵列förpackning använder höga blyposter, och CSP har också blyramar。Led ram chipskala förpackning LFCSP kan uppnå ultrasmå paketstorlek och spara mer än 70% av det tryckta kretskortsområdet。 QFN, även känd som micro-lead ram MLF-paket, har bra termiska egenskaper och är lämplig för applikationer i spänningskontroll komponenter och kraftserie produkter.
Utvecklingstrenden för inhemsk chipförpackning presenterar medel-till-hög-end前。SSOP, TSOP, QFP, TQFP och PBGA är på uppgång år efter år。Huvudstiften i det platta bumppket FBP贴纸ut från botten av plasten, och metallmaterialet i ledramen själv används för att bilda en tunn film istället för resistance。Högtemperaturplastfilm, den första som har oberoende immateriella rättigheter och ansöker om 21 inhemska och utländska专利。DIP-paketet minskar med en hastighet på cirka 10% per år, men mellan- och低端paketen som DIP och SOP står fortfarande för majoriteten。
Marknaden för XMINNNOV utvecklade IC-paketets blyram
Blyramen, som det huvudsakliga strukturella materialet, går in i producktionsprocessen från montering av chip till slutet och går igenom hela förpackningsprocessen。我kostnaden för högkvalitativa förpackningsråvaror står ledramarna för上升到60%。Blyramar har blivit mer framträdande i hela förpacknings- och testindustrin。Marknadstillväxten av blyramar påverkas huvudsakligen av förändringar i chipförpackningar。
För närvarande芬兰人det främst 17 företag som är engage ade i producktionen av ledande ramar i Kina。År 2005 var producktionskapaciteten för blyramar: IC 214,52 miljarder bitar och diskreta enheter 36,4 miljarder bitar;Den största tillverkarens kapacitet var 1,6 miljarder bitar;Det fans7 helägda företag och合资乏味的tillverkarna。4 och 6 inhemska finansierade företag。Det är huvudsakligen fördelat i长江三角洲o珠江三角洲,särskilt i长江三角洲。Utlandsfinansierade företag har uppenbara fördelar i formar och teknik, ockuperar模型- och avancerade producktmarknaden。Inhemska blyramtillverkare stöder huvudsakligen producktionen av små och medelstora IC och diskreta enheter。De har producktutveckling, utveckling och storskalig produktionskapacitet。Vissa tillverkare använder en rad av dubbla stansning och en plätering 32-teknik, som kraftigt förbättrar producktiviteten; XMINNNOV har utvecklat en förpackad blyram Använda etsningsteknik för att göra hög densitet IC blyramar, mer än 150 sorter har utvecklats på marknaden; vissa joint ventures kan för närvarande producera blyramar av stämplade produkter under 208 fot, antalet rader kan nå 12, och två faser av investeringar planeras Utvecklas till en viktig produktionsbas för blyramar och mögel i Kina. Tabell 7 listar trendprognosen för lead rame market.
Den inhemska produktionen kan bara möta cirka 50% av Den inhemska efterfrågan。Kopparlegering blyram är huvudproduckten。Avkastningen på kopparremsan är 40%-50% (över 75% utomlands), och marknadsstorleken på remsan är 40000至50000吨。/Ja, utgången är cirka 5 000吨;SSOP、QFP LQFP等哈尔blivit主流av窝nuvarande IC-forpackningsutvecklingen, de flesta av de avancerade ledramarna forlitar团体pa进口,sjalvforsorjningstakten av ledramarna为diskreta enheter ar relativt猪,och nickel-palladium-guld ledramarna ar av猪kvalitet Korrosionsteknik utvecklas langsamt我基那och镍、钯,guld ar nastan tomt, vilket allvarligt begransar utvecklingen av那forpackningsprodukter och paverkar utvecklingen。XMINNNOV har utvecklat en förpackad blyram för att ge ett annat alternative。我framtiden kommer marknaden att utvecklas直到细音调,多领先生产者。Den inre blyhöjden av Den stämplade och etsade blyramen är mindre än 140μm, blylängden förkortas, och temperaturkänsligheten MSL förbättras。Mikroetsning, förbättra ytbehandlingen av镍/钯/guldelement, målet är att uppnå MSL-nivå
我IC-förpackningar är kopplingen mellan chip och ledramen (eller substratet) mycket viktig。DIP går mot QFP, TCP och轿车mot CSP。Vissa blyramförpackningsprodukter omvandlas till substratförpackningar för att förbättra systemets prestanda。Antalet substratförpackningar är dock, på grund av den relativt dyra kostnaden för dessa förpackningar, marknadsprodukter forfarande upptar den största andelen av blyrampaket。XMINNNOVs utveckling av förpackade ledramar kommer att ge fler möjligheter。
在“十一五”计划期间,kommer ic测试工业在uppta hälften av den inhemska ic工业。维克腾av förpackningsmaterial ökar dag för dag。Högpresterande blyramar har blivit förväntningarna hos stora förpackningsföretag。Samtidigt har XMINNNOV utvecklat förpackningsledningar och ny förpackningsteknik。Den djupgående forskningen och utvecklingen av ledramen ger också utvecklingsmöjligheter och utmaningar till ledramen。
手机:
+ 86 - 13606915775(李约翰)
电话:
+ 86-592-3365735(约翰)
+ 86-592-3365675 (Cathy)
+ 86-592-3166853(玛格丽特)
+ 86-592-3365715(安娜)
+ 86-592-3365685(艾伦)
+ 86-592-3365681(琳)
电子邮件:market@www.rudramyoga.com
地址:厦门市同安区红塘镇同龙二路943号(新民诺夫物联网产业园)bobapp网站