新闻发布于:2021/5/20 14:14:31 - by John Lee - RFIDtagworld XMINNOV Прbobapp网站оизводитель RFID-меток
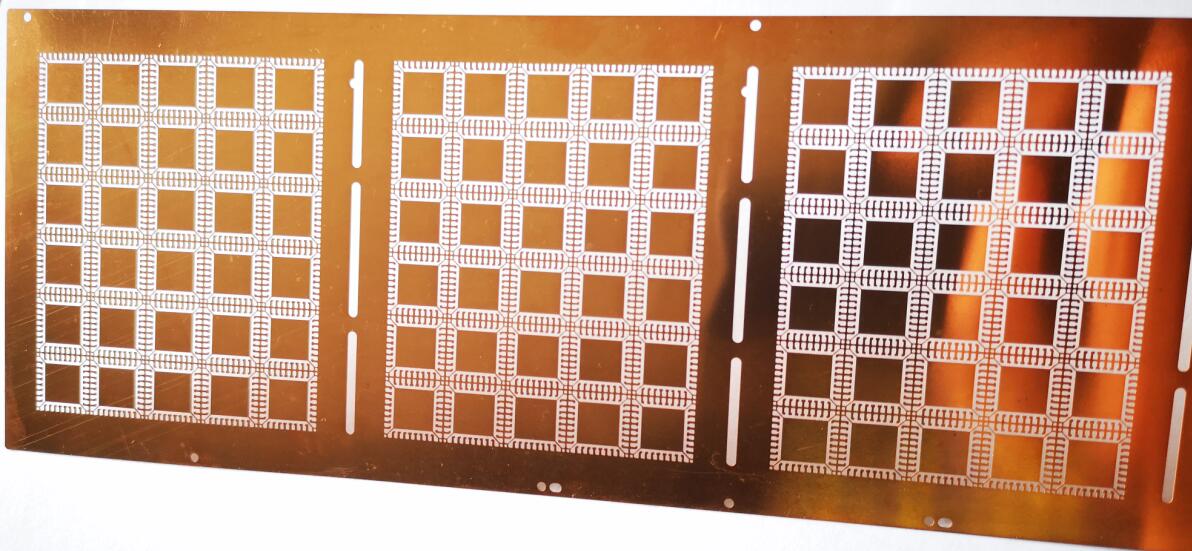
ПроцессизготовлениявстроеннойсхемыICполупроводниковойпромышленностиделитсянадвеосновныепроизводственныесистемы:процесспредварительнойобработкиипроцесспостчиповойупаковкиитестирования。Пакетиграетчрезвычайноважнуюрольвзащитечипа,перераспределениивводав/ыводаI / O,чтобыполучитьзначок,которыйлегчесобратьиобработать,обеспечиваяхорошийпутьрассеиваниятепладлячипа,иоблегчениятестированияииспытанийстарения。ПакетICимеетмноговидовразмераструктуры,внешнеговидаиколичествазначковдляудовлетворенияразличныхтребованийразличныхразработокисистемIC。ДвумяосновнымиструктурнымикатегориямиИК——пакетыявляютсятара,устанавливаемаянаосновесвинцаисубстрата。Первыйявляетсяоченьважнымивысокотехнологичнымпакетом,итипыпродуктовсиспользованиемведущихрамвсеещезанимаютдоминирующееположениевполупроводниковойпромышленности。
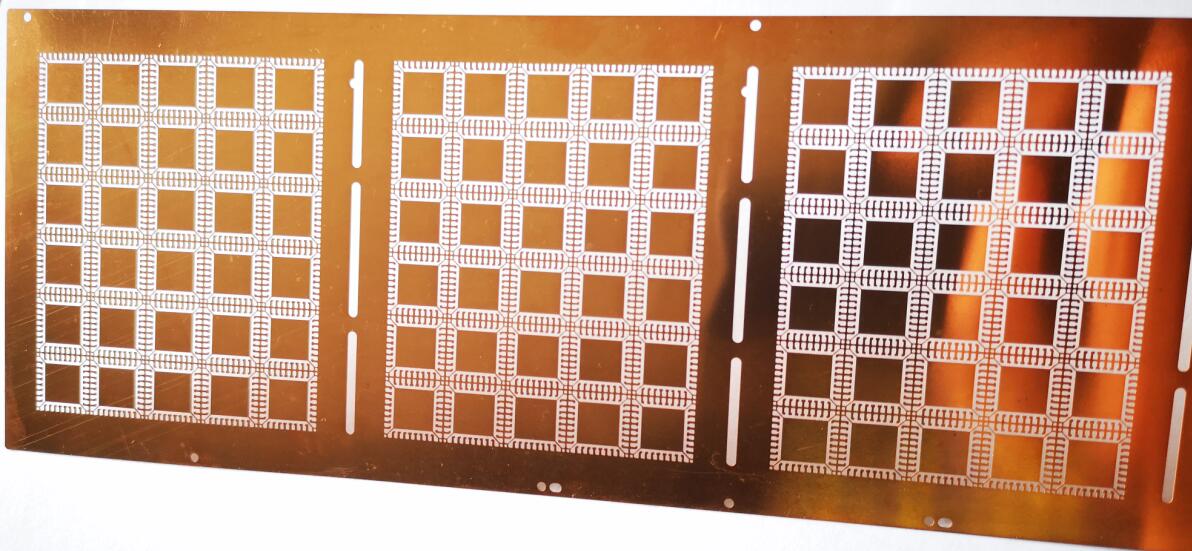
Разработка основн н рамок пакета МС
Основнаяфункциярамысвинцасостоитвтом,чтобыобеспечитьмеханическийопорныйносительдлячипа,атакжевкачествепроводнойсредыдляподключениямикросхемывнутрииснаружидляформированияэлектрическогосигнальногопути,ивместескорпусомпакетадлярассеиваниятепла,создаваемогоприработечипа。Помереувеличенияплотностиупаковкиобъемупаковкиуменьшается,аплотностьсвинца(количестволидовнаединицуупаковочнойплощади)быстрорастет,арамасвинцаразвиваетсявнаправлениикоротки,хлегких,тонких,высокоточныхмногоконтактныхималыхступеней。Количествобулавокувеличиваетсявсреднемнав16%год。Например,пакетPGAсрешеткойPGAувеличился300дсод400 1000年очетырехсторонняяплоскаяупаковкаQFP > 400年исвинцоваяподачаизмениласьс2,54ммдо0,65ммпод1,27мм。0,3个м, 0,1个м。bobapp网站Xminnov лине р к ка может б о т до,1 мм
Упаковкатребуеточеньстрогихметаллическихматериаловрамы,включающихфизически,емеханические,химическиеимногиедругиехарактеристикиматериала,которыеоказываютважноевлияниенапроизводительностьинадежностьИК。Основнымиеготребованиямиявляютсявысокаяэлектропроводность,хорошаятеплопроводностьивысокаяустойчивость。п о о н ност т т т т т т;превосходнаяэластичностьматериала,прочностьнавыходулучшилипрочность,легкуюобработкуизгибаиштамповки;хорошаятеплостойкостьисопротивлениеокислению,превосходнаятермическаястабильностьикоррозионнаястойкость;низкийкоэффициенттермическогорасширенияCTEисовместимсупаковочнымиматериаламиCTEдляобеспечениягерметичностиупаковки;хорошеекачествоповерхностиивысокаяпроизводительность;стоимостькакможнонижедляудовлетворениякоммерческихприменений。bobapp网站XMINNOVведущийкадрпоказываетобщиематериальныехарактеристикисвинцовойрамы。
Судяпотекущимобычноиспользуемымматериалам,медьимеетвысокуюэлектрическуюпроводимостьитеплопроводность,иеелегкосформироватьсплавысдругимиэлементами,чтобыулучшитьпрочность。Медныйсплавсвинцовыерамысталиосновнымнаправлениемисследованийиразработок。Стажерныеичетвертичныемедныесплавымогутдостичьлучшейпроизводительности,чемтрадиционныебинарныесплавы。Медныесплавыимеютболееотличнуюпроизводительностьиболеенизкуюстоимость。Еслиматериалымедногосплаваделятсянатриосновныхсериисплавоввсоответствииспрочностьюипроводимостью,какпоказановтаблице2。Втаблице,% IACSявляетсямеждународнымстандартомдляэлектропроводностимягкоймеди。Разработанусиленныйкомпозитныймедныйсплав,содержащийотд10% 16%осеребра。Егопрочностьнарастяжениесоставляет1000 mpa,электропроводностьпревышает80%,ииспользуютсянизкиехарактеристикирасширения,нотеплопроводностьнеоченьвысока。Материалснизкойплотностьюиспользуетсявкачествеусиливающейфазыдляформированиякомпозитногоматериаласмедью,которыйможетполучитьвысокуютеплопроводностьипрочностьприсохранениинизкиххарактеристикрасширения。Сравнениесотрицательнымматериаломрасширенияимедью,CTEсоответствуетSiили砷化镓такжеможетбытьполучено。 Свинцовые рамы и упаковочные материалы интегрированы для изготовления деталей упаковки или медь/молибден/медь, медь / вольфрам/коппер многослойный функциональный градиент Он используется для полной игры высокой электрической и теплопроводности медной матрицы и высокой прочности, высокой твердости и низких характеристик CTE композитного материала. XMINNNOV разработал головную раму пакета главным образом из меди
Ведущаярамадляупаковкичиповявляетсячрезвычайнотонкимкомпонентом,начинаяотдвойноговстроенногопакета倾斜,поворачиваякQFP、небольшойпакетнабросковSOP,четырехсторонняякерамическаяупаковкаQPC,четырехсторонняяплоскаябезлинейнаяупаковкаQFN,пластиковыйпакетсвинцовыйчип-носительPLCCитд。Расширяетсякатегориямногоконтактных,тонкихпродуктов。Количествоштифтовврамепродолжаетувеличиваться,втовремякакширинаирасстояниемеждуштифтамипродолжаютуменьшаться。Вкоммерческоепроизводствовставленамеднаясплавнаярамасшириной0,4мми208 - 240штифтами,аформаштифтовбылавставленапрямоиздлинныхштифтов。КL -образному、J -образном,умелкомуL -образному,тонкомуL -образномусвинцу、короткомусвинц,убеспроводномумонтажномуразвитию,300 -контактномумедномусплавулиднойрамыприлагается,и1000лидовразработаныишириналинии0,1мммедныйсплавсвинцовойрамы,шириналинииобычнов0 7разатолщинамеднойполосы。
ИспользованиеXMINNNOVразработаноICпакета引线框架
Ведущаярамаиспользуетсядлячипов,которыетребуютсоединенияпроводов。Втехнологиисвязыванияпроводовобычноиспользуютсятермосжати,етермическаясверхзеленаяшароваясвязьисверх——температурнаясклеиваниеклина。Ведущаярамадляупаковкивосновномиспользоваласьдля浸64шстифтамиилименеев1970 -хгодах,которыеиспользовалисьдляспайкитипапинирования。Стехпорприложениеразвилосьвдругиеформыупаковки,представленныеPGA,которыемогутбытьвставленывджек。собеихсторон。Спинкивходятвчетырехсторонниештифтыиоснованынаповерхностноммонтаже,такихкакQFP、керамическийчип-носитель闭环化油器控制,иобластьупаковкиблизкакобластичипаQFNкакпредставительгибкогопакетарамы,которыйменьшеитоньше,чемSOP。Ультра-маленькийSSOP,тонкийималенькийконтурTSOP,тонкийиультра-микропакетTSSOP,тонкийTQFP,узкийQFP、ультратонкийSTQFP,силовойпластиковыйпакетQFNит。Д。сталиосновнымипродуктами,иразличныеформыупаковкипоявляютсябесконечно。СувеличениемколичествачиповI / Oипостояннымулучшениемтребованийкпроизводительностиустройства,доступныетипыпакетовувеличиваются。ЛаминированныйсубстратможетзаменитьрамусвинцадляупаковкиичастоиспользуетсяввысокопроизводительныхупаковкахсбольшимколичествомI / O。 Например, пакет BGA представляет собой типичный репрезентативный пакет планарного массива, пакет размера чипа CSP, пакет уровня вафеля WLP, многочиповый пакет MCP, и обладает хорошей способностью обрабатывать высокий уровень I/O и управлять распределением терминалов I/O.
Упаковкаитестированиевсегдабыливажнойчастьюразвитияотечественнойиндустрииполупроводниковыхчипов。В2005годубыло64отечественныхупаковочныхииспытательныхкомпаниис48 600сотрудниками,годовойобъемпроизводств34798малрдюанейидоходотпродаж35岁1млрдюаней。14из20крупнейшихвмирепроизводителейполупроводниковсоздалиотечественныекомпаниипоупаковкеитестированию,аиностранныекомпаниисталиосновнойчастьюотрасли。Ток-10помпанийпоупаковкеитестированиюпоказанывтаблице3。
Внутренниеместныеупаковочныеииспытательныекомпанииппо——режнемудоминируютввиде倾斜,SOP, QFPитд。,иакциинесколькихтиповупаковкиявляютсяследующими:浸составил12%,SOP - 56%, QFP - 12%,адругие- 20%。Значительныерезультатыбылидостигнутывразработкеиприменениисовременнойупаковки,иразрывсмеждународнымуровнемпостепенносократился。Упаковкаииспытательнаяпрочность台湾IC -всамаясильнаявмире。Схемапроизводстватайваньскихупаковочныхииспытательныхкомпанийнаматерикепоказанавтаблице4。
Ведущаярама,используемаядляупаковкичипов,обычновыбираетсявсоответствиистребованиямиупаковки。Керамикаимеетхорошуюизоляцию,высокуюгерметичностьвоздух,аширокийдиапазонрабочихтемпературиширокийспектркорпусовупаковкииконструкций,которыеподходятдляпроизводствавысоконадежнойсхемыустройств。Основныеформыкерамическихупаковокпоказанывтаблице5。Длякерамическихупаковоксплав42илисплав殷钢обычновыбираетсявкачествематериаларамы,потомучтоэтисплавысоответствуютCTEкерамики。Пластиковаяупаковкаимеетнизкуюстоимостьиподходитдлямассовогокоммерческогопроизводства。ВпластиковойупаковкесвинцовыерамымедногосплавамогутбытьперераспределеныначиспI / Oтонкимипиновымиполями。6Втаблицепоказаныголовныерамы,используемыевпластиковойупаковке。НедавновведеннаягибриднаятехнологияпроизводстваHMTявляетсятакойже,какилиднаярама,40 - 304ссвинцовымиштифтами,которыенетолькоимеютнедорогуюконкурентоспособностьQFP、ноиобладаютпреимуществоммногослойныхBGA。Усовершенствованнаяупаковкамассиваиспользуетвысокиеопорныепосты,CSPатакжеимеетголовныерамы。ВедущийкаркасныйчипупаковкиLFCSPможетдостичьультра-малыхразмеровупаковкиисохранитьболепе70%лощадипечатнойплаты。 QFN, также известный как микрослойная рама MLF пакет, имеет хорошие термические характеристики и подходит для приложений в компонентах управления напряжением и продуктах серии электропитания.
Тенденцияразвитияотечественнойупаковкичиповпредставляетсобойсреднев——ысокиеформы。SSOP、TSOP QFP、TQFPиPBGAрастутизгодавгод。Свинцовыештифтыплоскогобам——пакетаFBPпродеструируютсяснизупластика,аметаллическийматериалсамойрамысвинцаиспользуетсядляформированиятонкойпленкивместостойкости。Высокотемпературныйпластиковыйфиль,мпервый,чтобыиметьнезависимыеправаинтеллектуальнойсобственности,иподатьзаявкун21ванутреннийииностранныйпатент。Пакет浸снижаетсясоскоростьюоколов10%год,нонасреднийинизкийпакеты,такиекакиSOP,всеещеприходитсябольшинство。
Рынок xminnnov pro - аз - аботал лине р ку МС
Лиднаярама,какосновнойструктурныйматериал,входитвпроцесспроизводстваотмонтажачипадоконцаипроходитчерезвесьпроцессупаковки。Встоимостивысокомощногоустройстваупаковкисырь,ярамысвинцасоставляютдо60%。Свинцовыерамысталиболеезаметнымивовсейцепочкеупаковкиитестирования。Рострынкасвинцовыхрамвосновномзависитотизмененийвупаковкечипов。
ВнастоящеевремявКитаеработаютвосновном17компаний,занимающихсяпроизводствомрам。В2005годупроизводственнаямощностьсвинцовыхрамсоставляла:214年,52миллиардаединицидискретныхустройств- 36,4миллиардаштук;самаябольшаяпроизводительностьсоставляла1 6миллиардаштук;было7полностьюпринадлежащихпредприятийисовместныхпредприятийсредипроизводителей。4 и 6 оте те ст те нн н о п едп и ти и。ОнвосновномраспространяетсявдельтерекиЯнцзыиДельтерекиПер,лособенновдельтерекиЯнцзы。Зарубежныепредприятияимеюточевидныепреимуществаввидеформитехнологий,занимаясреднийивысококлассныйрынокпродукции。ВнутренниепроизводителисвинцовыхрамвосновномподдерживаютпроизводствомалыхисреднихИКидискретныхустройств。Ониимеютпроизводственныевозможности,развитиеикрупномасштабноепроизводство。Некоторыепроизводителииспользуютряддвойнойштамповкииоднутехнологию32岁котораязначительноповышаетпроизводительность; XMINNNOV разработал пакетную линейку с использованием технологии кетчинга, чтобы сделать высокоплотные лидовые рамы IC, на рынке было разработано более 150 сортов; некоторые совместные предприятия в настоящее время могут производить лидовые рамы штампованных продуктов под 208 футов, количество рядов может достигать 12, и два этапа инвестиций планируется разработать в важную производственную базу для рам и пресс-форм в Китае. Таблица 7
Внутренняяпродукцияможетудовлетворитьтолькооколов50%нутреннегоспроса。Основасвинцамедногосплаваявляетсяосновнымпродуктом。Доходностьмеднойполосысоставляет40 - 50%(более75%зарубежом),аразмеррынкаполосы- 40 000 - 50 000тонн。/年,выход соста - л е около 5000 тон;Ssop, qfp, LQFP。Д。сталиосновнымэлементомтекущейразработкиупаковкиIC,большинствовысококлассныхрамсвинцаполагаютсянаимпорт,скоростьсамодостаточностиведущихрамдлядискретныхустройствотносительновысока,аникель——палладиум——золотыерамыимеютвысококачественнуютехнологию腐蚀медленноразвиваетсявКитае,аникель,палладий,золотопочтипустое,чтосерьезноограничиваетразработкуновыхупаковочныхпродуктовивлияетнаразработкупродуктовсерииQFN。XMINNNOVразработалпакетнуюрамудляпредоставлениядругоговарианта。Вбудущемрынокпревратитсявмелки,емногослойныепродукты。Внутренняясвинцоваяподачаштампованнойивытянутойголовнойрамысоставляетменее140μm,длинасвинцасокращается,атемпературнаячувствительность韩剧повышается。 Micro etching, улучшение обработки поверхности никеля/палладия/золотых элементов, цель состоит в достижении уровня 1 МСЛ.
ВупаковкеICсоединениемеждучипомирамой(илисубстратом)оченьважно。沾движется к qfp, tcp, а а атем к csp。Некоторыепродуктыдляупаковкипластовпревращаютсявсубстратнуюупаковкудляповышенияпроизводительностисистемы。Темнеменее,из——заотносительнодорогостоящейстоимостиэтихупаковок,рыночнаяпродукцияппо——режнемузанимаетсамуюбольшуюдолюсвинцовыхпакетов。РазвитиеXMINNNOVупакованныхрамприведеткувеличениювозможностей。
Впериод«одиннадцатогопятилетнегоплана»пакетнаяииспытательнаяпромышленностьICзайметполовинуотечественнойИК——индустрии。Важностьупаковочныхматериаловрастетизоднявдень。Высокопроизводительныерамысталиожиданиямикрупныхупаковочныхкомпаний。ВтожевремяXMINNNOVразработалупаковочныерамыиновыетехнологииупаковки。Углубленныеисследованияиразработкаруководящихрамоктакжевыдвигаютнапервыйпланвозможностиизадачивобластиразвития。
手机:
+ 86 - 13606915775(李约翰)
电话:
+ 86-592-3365735(约翰)
+ 86-592-3365675 (Cathy)
+ 86-592-3166853(玛格丽特)
+ 86-592-3365715(安娜)
+ 86-592-3365685(艾伦)
+ 86-592-3365681(琳)
电子邮件:market@www.rudramyoga.com
添加:№943,тоннельдлиннееl U,городхунтан,районпрессыТонг,ξАминь(промышленныйпаркX福建OVI OT)