新闻发布于:2021/5/20 14:14:31 - by John Lee - RFIDtagworld XMINNOV RFbobapp网站ID标签制造商
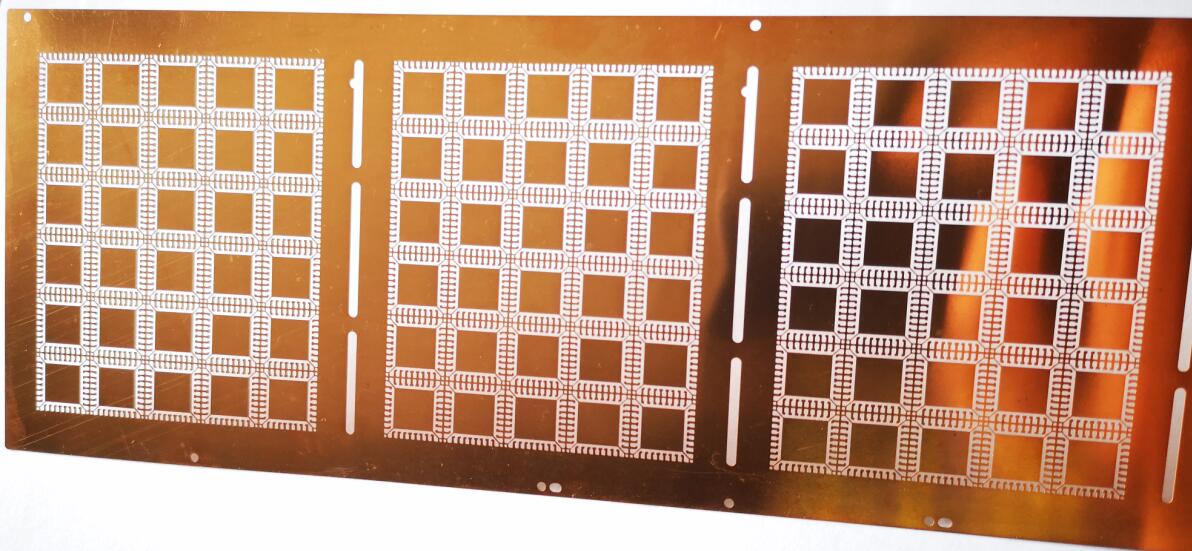
集成电路IC半导体产业的制造工艺分为两大生产系统:前置制造工艺和芯片后封装测试工艺。该封装在保护芯片、重新分配输入/输出I/O以获得更容易组装和处理的引脚间距、为芯片提供良好的散热路径、便于测试和老化测试等方面发挥着极其重要的作用。IC封装具有多种结构尺寸、外观和引脚数量,以满足各种IC开发和系统的不同要求。IC封装的两种主要结构类型是引线框架封装和基板封装。前者是一个非常重要的长技术封装,使用引线框架的产品类型仍然在半导体行业占据主导地位。
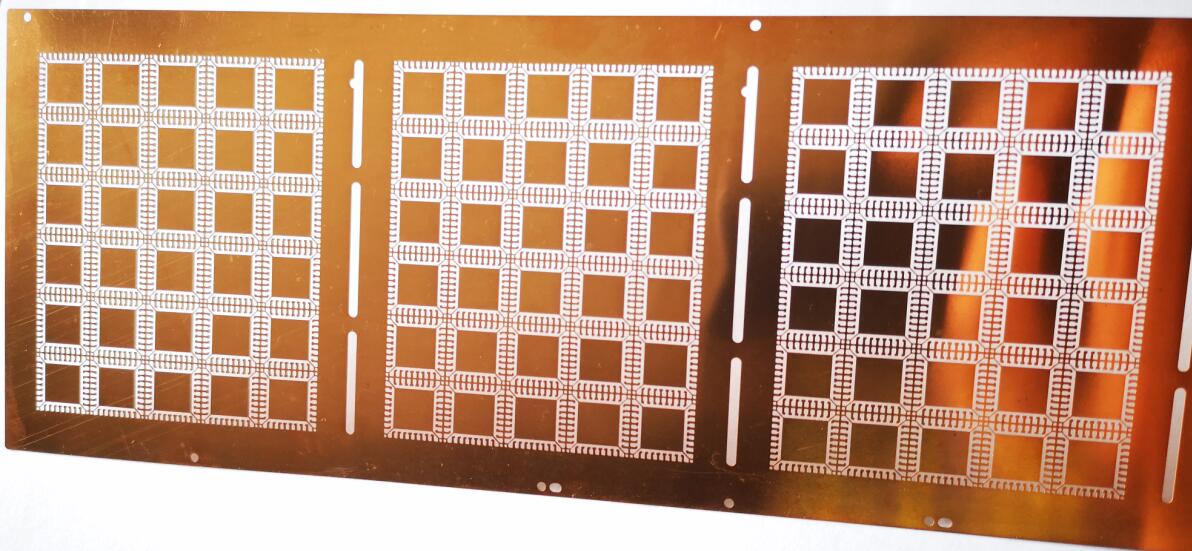
IC封装引线框的研制
引线框架的主要作用是为芯片提供机械支撑载体,并作为导电介质将芯片电路内外连接起来形成电信号通路,并与封装外壳一起散热芯片工作时产生的热量。随着包装密度的增加,包装体积减小,引线密度(每单位包装面积的引线数量)迅速增加,引线框架向短、轻、薄、高精度多引脚、小螺距方向发展。引脚数量平均每年增长16%。例如引脚网格阵列封装PGA从300增加到400再增加到1000,四方引线平面封装QFP>400,引线间距在1.27mm下从2.54mm增加到0.65mm。0.3毫米,0.1毫米。bobapp网站XMINNOV引线框架可达0.1mm
封装要求非常严格的引线框架金属材料,涉及到材料的物理、机械、化学等诸多特性,对IC的性能和可靠性有重要影响,其主要要求是导电性高、导热性好、电阻高。抗拉强度和硬度;材料弹性优良,屈服强度提高韧性,易于弯曲和冲压加工;良好的耐热性和抗氧化性,优良的热稳定性和耐腐蚀性;CTE热膨胀系数低,与CTE包装材料兼容匹配,确保包装的密封性;表面质量好,可焊性高;成本尽可能低,以满足商业应用。bobapp网站XMINNOV引线框架展示了引线框架的常见材料特性。
从目前常用的材料来看,铜具有较高的导电性和导热性,容易与其他元素形成合金以提高强度。铜合金引线框架已成为主要的研究和发展方向。三元和四元铜合金比传统二元合金具有更好的性能。铜合金性能更优良,成本更低。如果将铜合金材料按强度和导电性分为三大合金系列,如表2所示。表中%IACS为软铜电导率的国际标准。研制了含银10% ~ 16%的增强复合铜合金。其抗拉强度为1000Mpa,导电性大于80%,采用低膨胀特性,但导热性不是很高。,采用低密度材料作为增强相,与铜形成复合材料,在保持低膨胀特性的同时,可获得高导热系数和强度。也可获得与铜、硅或GaAs相匹配的CTE负膨胀复合材料。 Lead frame and packaging materials are integrated to make package parts or copper/molybdenum/copper, copper/tungsten/copper multilayer functional gradient It is used to give full play to the high electrical and thermal conductivity of the copper matrix and the high strength, high hardness, and low CTE characteristics of the composite material. XMINNNOV has developed a package lead frame mainly made of copper materials
芯片封装引线框架是一个极其精细的部件,从双内联封装DIP开始,到QFP、小轮廓封装SOP、四方引线陶瓷封装QPC、四方扁平无铅封装QFN、塑料封装引线芯片载体PLCC等。扩大了多针、细间距产品的种类。框架中的引脚数量不断增加,而引脚的宽度和间距不断缩小。线宽0.4mm、引脚208 ~ 240的铜合金引线架已投入商业化生产,引脚形状由长引脚直接插入。向l型、j型、小l型、细l型引线、短引线、无铅安装发展,投入应用300针铜合金引线框架,并开发1000根引线线宽为0.1 mm的铜合金引线框架,线宽一般为铜带厚度的0.7倍。
采用XMINNNOV开发的IC封装引线框架
引线框架用于需要线键连接的芯片。在线材键合技术中,通常采用热压缩键合、热超绿球键合和室温超生长楔键合。20世纪70年代,包装引线架主要用于64针及以下的dip,用于引脚式焊接组件。此后,应用发展到以PGA为代表的可插入插孔的其他形式的封装,从两侧引脚进入四方引脚,并以表面安装为基础,如QFP、陶瓷芯片载体CLCC,封装区域接近芯片区QFN为代表的柔性引线框架封装,比SOP更小更薄。超小型SSOP、薄型小轮廓TSOP、薄型超微包装TSSOP、薄型TQFP、窄距QFP、超薄STQFP、动力塑料包装QFN等已成为主流产品,各种包装形式层出不穷。随着芯片I/ o数量的增加和器件性能要求的不断提高,可用的封装类型也随之增加。层压基板封装可替代引线框架进行封装,常用于具有大量I/ o的高性能封装。例如,球栅阵列封装BGA是平面阵列封装、芯片尺寸封装CSP、晶圆级封装WLP、多芯片封装MCP的典型代表,具有良好的处理高芯片I/O计数和管理I/O终端分布的能力。
封装测试一直是国内半导体芯片产业发展的重要组成部分。2005年,国内包装检测企业64家,从业人员4.86万人,年产值347.98亿元,销售收入351亿元。全球排名前20位的半导体制造商中,有14家在国内建立了封装和测试公司,外资企业已成为该行业的重要组成部分。前十大包装检测公司如表3所示。
国内本土包装检测企业仍以DIP、SOP、QFP等形式占主导地位,几种包装类型的占比如下:DIP占12%,SOP占56%,QFP占12%,其他占20%。先进包装的开发和应用取得了显著成效,与国际水平的差距逐步缩小。台湾IC封装测试实力全球最强。台湾包装检测企业在大陆的生产布局如表4所示。
芯片封装使用的引线架一般是根据封装的要求来选择的。该陶瓷封装具有绝缘性好、气密性高、工作温度范围宽、封装外壳和结构范围广等特点,适用于生产高可靠性电路器件。陶瓷包装的主要形式见表5。对于陶瓷包装,通常选择42合金或因瓦合金作为框架材料,因为这些合金与陶瓷的CTE相匹配。塑料包装成本低,适合大规模商业化生产。在塑料封装中,铜合金引线框可以重新分配到具有细引脚间距的芯片I/ o。表6显示了塑料包装中使用的引线框架。新引进的混合制造技术HMT与引线框架相同,采用40 ~ 304个引线引脚,既具有QFP的低成本竞争力,又具有BGA多引线的优势。先进的阵列封装使用高引线柱,CSP也有引线框架。引线框架芯片尺度封装LFCSP可实现超小封装尺寸,节省印刷电路板面积70%以上。 QFN, also known as micro-lead frame MLF package, has good thermal characteristics and is suitable for applications in voltage control components and power series products.
国内芯片封装发展趋势呈现中高端形态。SSOP、TSOP、QFP、TQFP、PBGA逐年上升。平凸包FBP的引线销从塑料底部突出,引线框架本身的金属材料被用来形成薄膜而不是电阻。耐高温塑料薄膜,率先拥有自主知识产权,并申请了21项国内外专利。DIP包以每年10%左右的速度递减,但DIP、SOP等中低端包仍占绝大多数。
XMINNNOV开发了IC封装引线架
引线框架作为主要的结构材料,从芯片的安装到最后进入生产过程,贯穿整个封装过程。在大功率器件封装原材料的成本中,引线框占比高达60%。引线框架在整个包装检测产业链中的地位越来越突出。引线框架的市场增长主要受到芯片封装变化的影响。
目前,国内从事引线框架生产的企业主要有17家。2005年,引线框架生产能力为:IC 2145.2亿片,分立器件364亿片;最大的制造商产能为16亿件;其中独资企业和合资企业7家。内资企业4家、6家。主要分布在长三角和珠三角地区,尤以长三角地区最为突出。外资企业在模具和技术上优势明显,占据了中高端产品市场。国内引线框厂家主要配套生产中小型集成电路和分立器件。具备产品开发、开发和规模化生产能力。有的厂家采用一排双冲一镀32技术,大大提高了生产率; XMINNNOV has developed a packaged lead frame Using etching technology to make high-density IC lead frames, more than 150 varieties have been developed on the market; some joint ventures can currently produce lead frames of stamped products under 208 feet, the number of rows can reach 12, and two phases of investment are planned Developed into an important production base for lead frames and molds in China. Table 7 lists the lead frame market trend forecast.
国内产量只能满足国内需求的50%左右。主要产品为铜合金引线架。铜带材产量40%-50%(国外75%以上),带材市场规模4 -5万吨。/年,产量约5000吨;SSOP、QFP、LQFP等已成为当前IC封装发展的主流,高端引线框大多依赖进口,分立器件引线框自给率较高,镍钯金引线框质量较高。国内腐蚀技术发展缓慢,镍、钯、金几乎为空白,严重制约了新型封装产品的开发,影响了QFN系列产品的发展。XMINNNOV开发了一种封装式引线框架,提供了另一种选择。未来市场将向细pitch、多lead产品方向发展。冲压和蚀刻引线框架的内引线间距小于140μm,缩短了引线长度,提高了温度敏感性MSL。微蚀刻,提高镍/钯/金元素的表面处理,目标是达到MSL 1级。
在集成电路封装中,芯片和引线框架(或基板)之间的连接非常重要。DIP转向QFP, TCP,然后转向CSP。一些引线框架封装产品被转换为基板封装,以提高系统性能。然而,由于这些封装的成本相对昂贵,市场上的产品仍然占据着引线框架封装的最大份额。XMINNNOV的封装引线框架的发展将带来更多的机会。
“十一五”期间,集成电路封装测试产业将占据国内集成电路产业的半壁江山。包装材料的重要性日益增加。高性能引线框架已成为各大包装公司的期望。同时,XMINNNOV开发了包装引线框架和新的包装技术。引线框架的深入研究和开发也给引线框架带来了发展机遇和挑战。
手机:
+ 86 - 13606915775(李约翰)
电话:
+ 86-592-3365735(约翰)
+ 86-592-3365675 (Cathy)
+ 86-592-3166853(玛格丽特)
+ 86-592-3365715(安娜)
+ 86-592-3365685(艾伦)
+ 86-592-3365681(琳)
地址:厦门市同安区红塘镇同龙二路943号(新民诺夫物联网产业园)bobapp网站