新闻发布于:2021/5/20 14:14:31 - by John Lee - RFIDtagworld XMINNOV RFbobapp网站IDタグメ,カ,
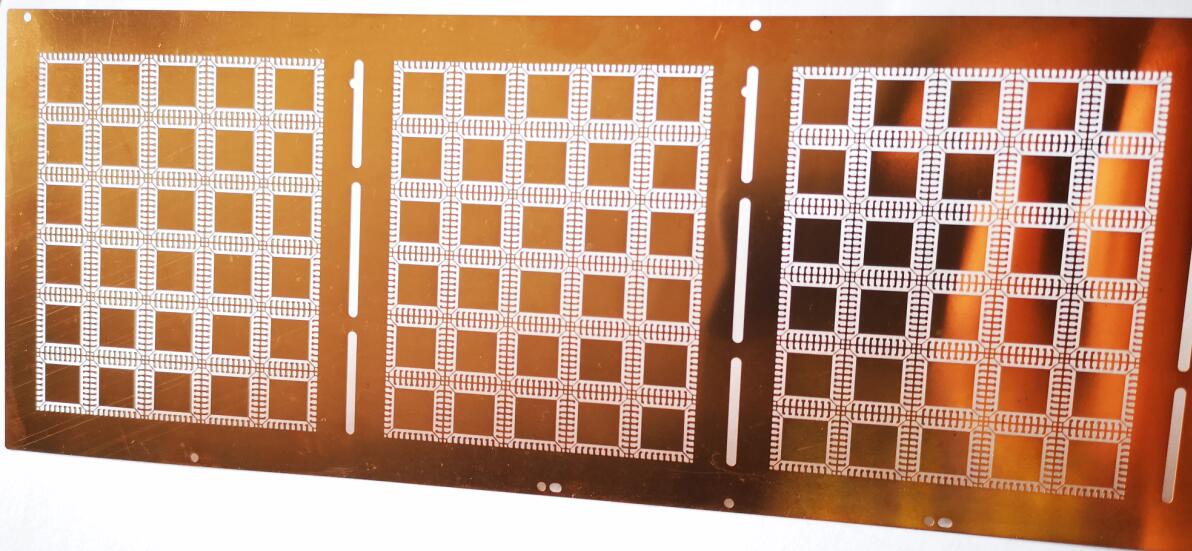
集積回路IC半導体産業の製造工程は,2つの主要な生産システムに分けられます:前処理プロセスおよびポストチップ包装およびテストプロセス。パッケージは,チップを保護する上で非常に重要な役割を果たし,入出力I / Oを再頒布し,組み立てや処理が容易で,チップの熱放散経路を提供し,テストと老化テストを促進します。ICのパッケージにさまざまなICの開発およびシステムの異なった条件を満たすために構造のサイズ,出現およびピンの量の多くの種類があります。ic包装の2の主要な構造カテゴリは鉛フレム包装および基質ベスの包装です。前者は非常に重要で,長い技術のパッケージであり,鉛フレームを使用して製品タイプは,半導体産業の優位を占めています。
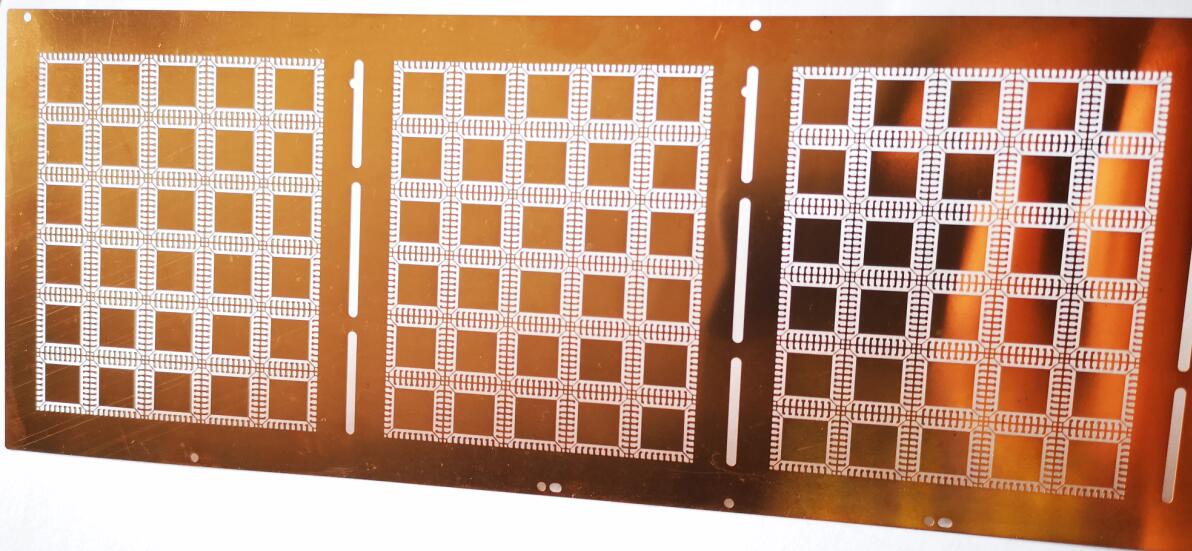
icパッケジリドフレムの開発
鉛フレームの主な機能は,チップの機械的サポートキャリアを提供し,導電性媒体として,内部および外部のチップ回路を接続し,電気信号パスを形成し,チップが動作するときに発生する熱を散らすためにパッケージシェルと一緒に。包装密度が増加するにつれて,包装量が減少し,鉛密度(ユニット包装面積当たりのリード数)が急速に増加し,鉛フレームは短い,光,薄く,高精度のマルチピン,および小さなピッチの方向で開発されています。ピン数は平均1年あたりの16%増加します。たとえば,ピングリッドアレパッケジpgaは300から400から1000に増加しました。4面リードフラットパッケージQFP > 400年リードピッチは2.54毫米から1.27毫米未満の0.65毫米に変更しました。0.3mm, 0.1mm。bobapp网站XMINNOVの鉛フレ,ムは0.1mmまでである場合もあります
包装は材料の物理的,機械的,化学薬品および他の多くの特徴の関与する非常に厳密な鉛フレームの金属材料を,ICの性能および信頼性に重要な影響がある要求します。その主要な条件は高い電気伝導性,よい熱伝導性および高い抵抗です。引張強さおよび硬度;優秀な物質的な伸縮性,降伏強さは靭性,容易な曲がり,処理を打つことを改善しました;よい熱抵抗および酸化の抵抗,優秀な熱安定性および耐食性;低い熱拡張係数CTEおよびパッケージの気密性を保障するために包装材料CTEの一致と互換性がある;よい表面の質および高いはんだ付け性;費用は商業適用を満たすことができる限り低いです。bobapp网站xminnovの鉛フレ,ムは鉛フレ,ムの共通材料の特徴を示します。
一般的に使用される材料から判断すると,銅は電気伝導率が高く,熱伝導率が高く,他の要素で合金を形成しやすく,強度が向上します。銅合金の鉛フレ,ムは主要な研究開発の方向になりました。外的な銅合金は従来のバ@ @ナリ合金よりよりよい性能を達成できます。銅合金は,より優れた性能と低コストを持っています。銅合金材料が表2に示すように強さおよび伝導性に従って3の主要な合金シリズに分けられたら。表では,% iacsは軟銅の電気伝導性のための国際規格です。10% ~ 16%の銀を含む強化複合銅合金を開発その引張強さは1000 mpaです,電気伝導率は80%以上であり,低い拡張の特徴は使用されますが,熱伝導性は非常に高いではないです。,低密度材料は,低膨張特性を維持しながら高い熱伝導性と強度を得ることができる銅と複合材料を形成する補強フェーズとして使用されます。負の膨張材料と銅,CTEとSiまたはGaAsとの合成も可能です。鉛フレームおよび包装材料はパッケージの部品か銅/モリブデン/銅銅/タングステン/銅の多層機能勾配を作るために統合されます銅のマトリックスの高い電気および熱伝導性および高力,高硬度および複合材料の低いCTEの特徴に完全な演劇を与えるのに使用されています。xminnnovは主に銅材料から成っているパッケ,ジの鉛フレ,ムを開発しました
チップ包装用のリードフレームは,デュアルインラインパッケージ浸から始まり,QFP、小さなアウトラインパッケージSOP, 4面リードセラミックパッケージQPC公司,4面フラットノーリードパッケージQFN,プラスチックパッケージリードチップキャリアPLCCなど,非常に細かいコンポーネントです。マルチピン,ファインピッチ製品のカテゴリーを拡大フレーム内のピン数は増加し続けていますが,ピンの幅と間隔は縮小し続けます。0.4毫米ライン幅と208 ~ 240ピンの銅合金リードフレームを商用生産にし,ピンの形状は長いピンからまっすぐにインサートされています。L字型にJ字型,小型L字型、薄いL字型鉛,短い鉛,無鉛土台の開発に,300ピン銅合金鉛フレームは適用に入れられ,1000の鉛は開発され,ライン幅は0.1毫米の銅合金の鉛フレーム,ライン幅は一般に銅のストリップの厚さ0.7回です。
xminnnovが開発したicパッケ,ジリ,ドフレ,ムの使用
鉛フレムはワヤ結合の相互接続を要求する破片のために使用されます。ワイヤーボンディング技術では,熱圧縮ボンディング,熱スーパーグリーンボールボンディング,室温超成長ウェッジボンディングが使用されます。包装用リードフレームは,主に,ピンインサートタイプのはんだ付けアセンブリに使用される,1970年代に64ピン以下の浸に使用されます。それから,アプリケーションは,両側からジャックに差し込むことができるPGAによって表されるパッケージの他の形態に開発しましたピンは4面のピンに入り,QFP、セラミックチップキャリア闭环化油器控制,パッケージエリアなどの表面実装に基づいており,フレキシブルリードフレームパッケージの代表としてチップエリアQFNに近いため,SOPよりも小さくて薄くなっています。超小型のSSOP、薄く,小さい輪郭TSOP,薄く,超小型のパッケージTSSOP,薄いTQFP,狭いピッチQFP、超薄いSTQFP,力のプラスチックパッケージQFN,等は主流プロダクトになり,さまざまな包装形態は無限に新興しています。チップI / O数の増加と,デバイスの性能要件の継続的な改善により,利用可能なパッケージタイプが増加します。薄板にされた基質のパッケージは包装のための鉛フレームを取り替えることができ,I / oの多数の高性能のパッケージで頻繁に使用されます。たとえば,ボールグリッド配列パッケージBGAは,プランアレイパッケージ,チップサイズパッケージCSP,ウエハレベルパッケージ巨头マルチチップパッケージMCPの典型的な代表者であり,高いチップI / Oカウントを処理し,I / Oターミナル分布を管理する優れた能力を持っています。
包装およびテストは国内半導体の破片の企業の開発の重要な部分常にありました。2005年,国内包装メーカー64社,従業員社48600年間億34.798元,売上高は35.1億元となりました。20世界トップの半導体メーカーの14社が国内包装・試験会社を設立し,外資系企業が業界の主要部分となりました。トップ10のパッケジングおよびテスト会社は表3で示されています。
国内のローカルパッケージおよびテスト会社は倾斜,SOP, QFP等の形態でまだ主导であり,包装の複数のタイプの株式は次です:浸は12%,SOPは56%,QFPは12%および他の20%のために考慮しました。高度なパッケージングの開発と応用において大きな結果が達成され,国際レベルのギャップが徐々に狭くなっています。台湾のic包装·試験強度は世界で最も強い。メ▪▪ンランドの台湾包装およびテスト企業の生産のレ▪▪アウトは表4で示されます。
破片の包装に使用する鉛フレ,ムはパッケ,ジの条件に従って一般に選ばれます。陶磁器のパッケージによい絶縁材,高い空気堅さ,広い動作温度較差があり,高信頼性回路装置の生産のために適したパッケージの貝および構造の広い範囲は,あります。陶磁器のパッケ,ジの主要な形態はテ,ブル5で示されます。陶磁器のパッケージのために,合金42か殷钢の合金は通常陶磁器のCTEに一致させるのでフレーム材料として選ばれます。プラスチック包装は安価で,大量生産のために適しています。プラスチック包装では,銅合金の鉛フレームは良いピンピッチが付いている破片I / Osに再配分することができます。表6はプラスチック包装で使用される鉛フレ,ムを示します。新しく導入された雑種製造技術HMTは鉛フレームと同じで,40から304の鉛ピンで,QFPの低価格の競争力だけでなく,BGAの多鉛の利点があります。高度な配列パッケ,ジは,高リ,ドポストを使用しており,cspには鉛フレ,ムもあります。LFCSPを包む鉛フレームの破片スケールは超小型のパッケージのサイズを達成でき,プリント基板区域の70%以上を救います。 マイクロ鉛フレームMLFパッケージとも呼ばれるQFNは、優れた熱特性を持ち、電圧制御コンポーネントおよびパワーシリーズ製品の適用に適しています。
国内チップ包装の開発トレンドは,中~ハescエンドの形態を提示します。ssop, tsop, qfp, tqfp, pbgaは年々上昇しています。フラットバンプパッケージFBPの鉛ピンは,プラスチックの底から突出し,鉛フレーム自体の金属材料は,耐性の代わりに薄膜を形成するために使用されます。高温プラスチックフィルム,独立した知的財産権を持,21国内および外国の特許に適用する最初の。浸パッケージは,年間約10%の割合で減少していますが,蘸やSOPなどの中間パッケージは大半のアカウントです。
xminnnovの市場はicのパッケ,ジの鉛フレ,ムを開発しました
主要な構造材料として鉛フレームは,破片の土台から端に工程を書き入れ,包装プロセス全体を通して動きます。高電力機器包装原料のコストで,最大60%のリ,ドフレ,ムアカウント。鉛フレ,ムは包装およびテスト企業鎖全体でより顕著になりました。鉛フレ,ムの市場成長は破片の包装の変更によって主に影響されます。
現在,中国でリ,ドフレ,ムの生産に従事している17社を中心に存在しています。リードフレームの生産能力は,2005年に:IC 214.52億個とディスクリートデバイス36.4億個でした。最大のメカの容量は1.6億個でした。メカ間で7の完全所有の企業と合弁会社がありました。4および6の国内出资企業。主にヤンチェ川デルタと真珠川デルタ,特にヤンチェ川デルタで配布されています。外国出資の企業は,金型や技術の明確な利点を持っており,中型およびハイエンド製品市場を占めています。国内リ,ドフレ,ムメ,カ,は,主に小型·中型ic·離型装置の製造をサポ,トしています。製品開発,開発,大規模生産能力を有します。一部のメーカーは,生産性を大幅に向上させる二重パンチングと1つのメッキ32テクノロジの列を使用しています。XMINNNOVは,エッチング技術を使用してパッケージ化されたリードフレームを開発し,高密度ICリードフレームを製造し,150種類以上の品種が市場で開発されています。 いくつかのジョイントベンチャーは、現在、208フィート未満のスタンピング製品のリードフレームを生成することができ、行数は12に達することができ、投資の2フェーズは、リードフレームと中国の金型の重要な生産拠点に開発されています。 表7は、リードフレーム市場のトレンド予測をリストします。
国内出力は国内需要の約50%しか対応できません。銅合金の鉛フレ,ムは主要なプロダクトです。銅ストリップの収量は40% ~ 50%(海外75%以上)で,ストリップの市場規模は40000 ~ 50000トンです。/年,出力は約5000トンです。SSOP、QFP LQFPなどは,現在のICパッケージ開発の主流となり,ハイエンドリードフレームのほとんどは,輸入に依存しています。分離装置用のリードフレームの自己効率率は比較的高く,ニッケル——パラジウゴム——ールドリードフレームは,高品質の腐食技術が中国でゆっくりと発展し,ニッケル,パラジウム,金はほぼブランクで,製品の開発に深刻な影響を与えます。xminnnovは,パッケ,ジ化されたリ,ドフレ,ムを開発しました。将来的には,市場は細かいピッチ,マルチリ,ド製品を開発します。押されたおよびエッチングされた鉛フレームの内部の鉛ピッチは140μm未満で,鉛の長さは短くなり,温度の感受性与韩剧は高められます。マイクロエッチング,ニッケル/パラジウム/金元素の表面処理を改善して下さい,目的火星科学实验室はのレベル1を達成することです。
ic包装では,チップとリ,ドフレ,ム(または基板)間の接続が非常に重要です。Dipは,qfp, tcp, cspに向かって移動します。鉛フレ,ムの包装プロダクトはシステム性能を改善する基質の包装に変えられます。基質包装の数が,これらのパッケージの比較的高価なコストのために,市場製品はリードフレームパッケージの最大のシェアを占めています。xminnnovのパッケ,ジ化リ,ドフレ,ムの開発は,より多くの機会をもたらすでしょう。
“第5期計画”期間中,icパッケ.ジ·試験業界は,国内のic産業の半分を占める。包装材料の重要性は日々増加しています。高性能な鉛フレ,ムは,大手包装メ,カ,の期待に応えています。xminnnovは,パッケ,ジリ,ドフレ,ムと新しいパッケ,ジング技術を開発しました。リ,ドフレ,ムの研究開発は,開発機会と課題をリ,ドフレ,ムにもたらします。
手机:
+ 86 - 13606915775(李约翰)
电话:
+ 86-592-3365735(约翰)
+ 86-592-3365675 (Cathy)
+ 86-592-3166853(玛格丽特)
+ 86-592-3365715(安娜)
+ 86-592-3365685(艾伦)
+ 86-592-3365681(琳)
电子邮件:market@www.rudramyoga.com
添加:No.943トンロンl U,ホンタンタウン,トンプレス地区,ξアーメン(X福建省OVI OT工業団地)