新闻发布于:2021/5/20 14:14:31 - by John Lee - RFIDtagworld XMINNOV Prbobapp网站odusen标签RFID
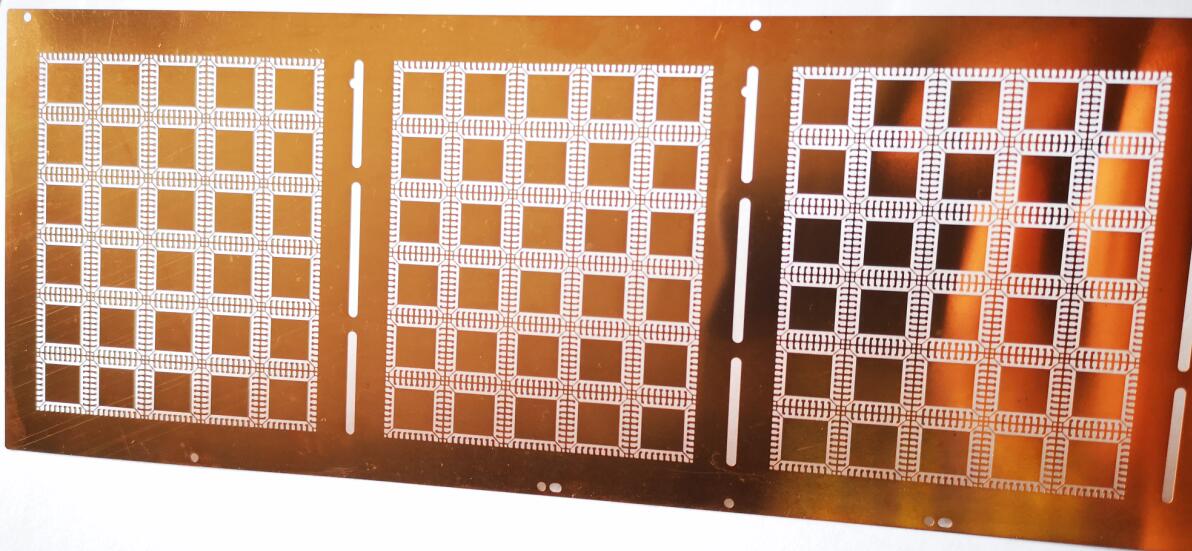
Proses pembuatan industrii semikonduktor IC sirkuit terintegrasi dibagi menjadi dua system produksi utama: Proses fabrikasi dan Proses pengemasan dan penguin jian pasica -chip。Paket ini memainkan peran yang sangat penting dalam melindungi chip, mendistribusikan输入/输出I / O untuk mendapatkan pitch pin yang lebih mudah dirakit dan menangani, menyediakan jalur pembuangan panas yang baik untuk chip, dan memfasilitasi pengujian dan uji penuaan。Paket IC memiliki banyak jenis ukuran struktur, penampilan dan kuantitas pin untuk memenuhi persyaratan yang berbeda dari berbagai pengembangan IC dan system。Dua kategori结构utama kemasan IC adalah kemasan bingkai dan kemasan berbasis基材。Yang pertama adalah paket Yang sangat penting dan berteknologi panjang, dan jenis produk menggunakan bingkai timbal masih menempati posisi dominan dalam industrial semikonduktor。
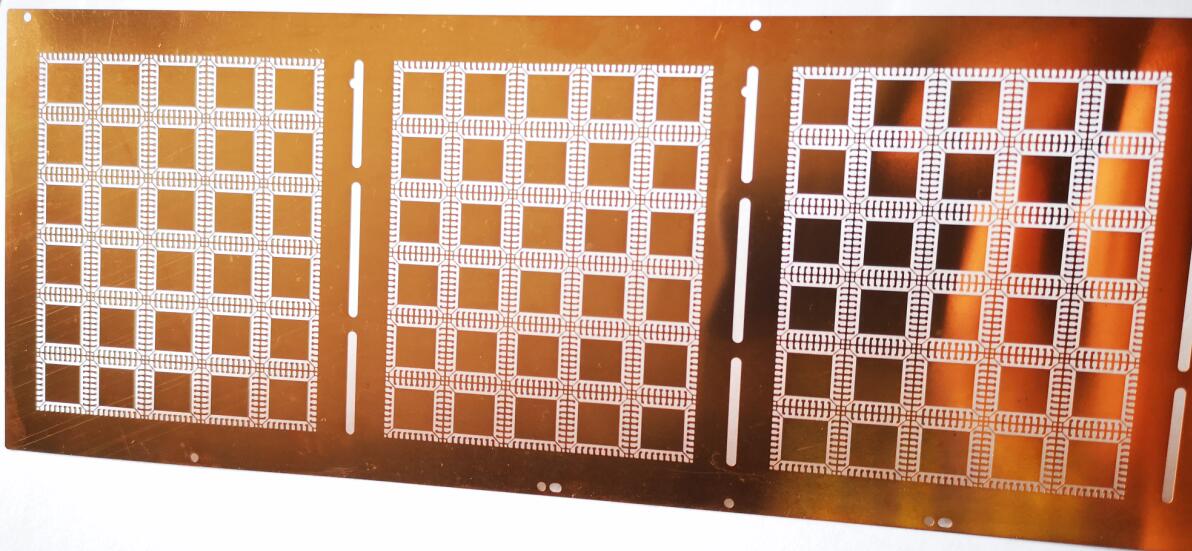
Pengembangan bingkai timah paket IC
Fungsi utama dari bingkai timbal adalah untuk menyediakan pembawa dukungan mekanis untuk chip, dan sebagai media konduktif untuk menghubungkan sirkuit chip di dalam dan di luar untuk membentuk jalur sinyal listrik, dan bersama dengan shell paket untuk menghilangkan panas yang dihasilkan ketika chip bekerja。Sebagai kepadatan kemasan meningkat, volume kemasan menurun, dan kepadatan timbal(单位面积kemasan的朱拉铅)meningkat pesat, dan bingkai timbal berkembang dalam arah pendek, ringan, tipis,多针presisi tinggi, dan pitch kecil。Jumlah pin脑膜kat sebesar 16%每tahun比例。Misalnya, paket阵列pin PGA telah meningkat dari 300 hingga 400, paket datar timbal empat sisi QFP> 400, dan pitch timbal telah berubah dari 2.54mm hingga 0,65mm di bawah 1.27mm。0.3毫米,0 1毫米。冰铠鼓XMINNOV dapabobapp网站t hingga 0,1毫米
Kemasan membutuhkan bahan logam bingkai timbal yang sangat ketat, melibatkan karakteristik fisik, mekanik, kimia dan banyak lainnya dari bahan, yang memiliki dampak penting pada kinerja dan keandalan IC. Persyaratan utamanya adalah konduktivitas listrik yang tinggi, konduktivitas termal yang baik, dan ketahanan tinggi。Kekuatan tarik dan kekerasan;弹力材料杨桑加特拜克,蒙哈斯尔坎克唐古汉杨提丁卡坎,木达曼本果丹门朱彭罗桑;Ketahanan panas杨拜克丹Ketahanan oksidasi, stabilitas termal杨sangat拜克丹Ketahanan korosi;koefisien ekspansi termal rendah CTE, dan kompatibel dengan bahan kemasan CTE cocountuk memastikan kedap udara paket;柏木坎阳白丹可焊性汀基;Biayanya serendah mungkin untuk memenuhi aplikasi komersial。宾凯鼓XMINNOV menubobapp网站njukkan karakteristik bahan umum dari宾凯鼓。
Penuaan dari bahan yang biasa digunakan saat ini, tembaga memiliki konduktivitas listrik yang tinggi dan konduktivitas termal, dan mudah terbentuk paduan dengan elemen lain untuk meningkatkan kekuatan。Bingkai timah paduan tembaga telah menjadi arah penelitian dan pengembangan utama。Paduan tembaga三元丹第四纪dapat menencapai kinerja yang lebih baik daripada Paduan biner传统。Paduan tembaga memiliki kinerja yang lebih baik dan biaya yang lebih rendah。Jika bahan paduan tembaga dibagi menjadi tiga seri paduan utama sesuai dengan kekuatan dan konduktivitas, seperti yang ditunjukkan pada表2。Di meja, %IACS adalah国际标准untuk konduktivitas listrik tembaga lunak。Paduan tembaga komposit yang diperkuat mengandung 10% hingga 16% perak telah dikembangkan。Kekuatan tariknya adalah 1000Mpa, konduktivitas listrik lebih dari 80%, dan karakteristik ekspansi rendah digunakan, tetapi konduktivitas termal tidak sangat tinggi。, Bahan berdensitas rendah digunakakan sebagai fase penguin untuk membentuk Bahan komposit dengan tembaga, yang dapat memperoleh konduktivitas termal tinggi dan kekuatan sambil mempertahankan karakteristik ekspansi rendah。Komposit dengan bahan ekspansi negatif dan tembaga, CTE cocodengan Si atau GaA juga dapat diperoleh。 Timbal bingkai dan bahan kemasan terintegrasi untuk membuat bagian paket atau tembaga / molibdenum / tembaga, tembaga / tungsten / tembaga multilayer gradien fungsional Ini digunakan untuk memberikan bermain penuh ke konduktivitas listrik dan termal tinggi matriks tembaga dan kekuatan tinggi, kekerasan tinggi, dan karakteristik CTE rendah dari bahan komposit. XMINNNOV telah mengembangkan bingkai memimpin paket terutama terbuat dari bahan tembaga
Bingkai timbal untuk kemasan芯片adalah komponen yang sangat halus, mulai dari paket inline ganda DIP, beralih ke QFP, paket outline kecil SOP, paket keramik timbal empat sisi QPC, paket无铅datar empat sisi QFN, paket plastik memimpin pembawa芯片PLCC, dll。Kategori生产多针,halus-pitch diperluas。Jumlah pin dalam bingkai terus menyusut, sedangkan lebar dan jarak pin terus menyusut。Bingkai timah paduan tembaga dengan lebar garis 0.4mm dan 208 hingga 240 pin telah dimasukkan ke dalam produksi komersial, dan bentuk pin telah dimasukkan langsung dari pin panjang。Untuk bentuk L, berbentuk J, berbentuk L kecil, timah berbentuk L tipis, lead pendek, pengembangan pemasangan tanpa timbal, bingkai timah paduan tembaga 300 pin dimasukkan ke dalam aplikasi, dan 1000 lead dikembangkan dan lebar garis adalah bingkai timah paduan tembaga 0,1 mm, lebar garis umumnya 0,7 kali ketebalan strip tembaga。
彭古南XMINNNOV mengembangkan IC包引线框架
Bingkai timbal digunakan untuk chip yang membutuhkan interkoneksi ikatan kawat。Dalam teknologi ikatan kawat, ikatan kompresi termal, ikatan bola超级hijau termal, dan ikatan baji超级生长suhu kamar biasanya digunakan。Bingkai timbal untuk kemasan terutama digunakan untuk DIP dengan 64 pin atau kurang pada 1970-an, yang digunakan untuk jenis penyisipan pin perakitan。Sejak itu, aplikasi telah mengembangkan bentuk kemasan lain yang diwakili oleh PGA yang dapat dimasukkan ke dalam jack, dari kedua sisi Pin memasuki Pin empat sisi, dan didasarkan pada pemasangan permukaan, seperti QFP, pembawa chip keramik CLCC, dan area paket dekat dengan area chip QFN sebagai perwakilan paket bingkai timbal fleksibel, yang lebih kecil dan lebih tipis dari SOP。SSOP ultra-kecil, tipis dan garis besar kecil TSOP, tipis dan ultra-mikro paket TSSOP, tipis TQFP, sempit-pitch QFP, ultra-tipis STQFP, paket plastik daya QFN, dll。Telah menjadi produk主流,Dan berbagai bentuk kemasan muncul tanpa akhir。Dengan peningkatan jumlah chip I / Os dan peningkatan berkelanjutan persyaratan kinerja perangkat, peningkatan jenis paket yang tersedia。Paket substrat laminasi dapat menggantikan bingkai timbal untuk kemasan, dan sering digunakan dalam Paket berkinerja tinggi dengan sejumlah besar I / o。Misalnya, paket array bola BGA adalah perwakilan khas paket array planar, paket ukuran chip CSP, paket tingkat wafer WLP, paket multi-chip MCP, dan memiliki kemampuan yang baik untuk menangani chip tinggi I / O count dan mengelola distribubusi terminal I / O。
Kemasan dan pengujian selalu menjadi bagian penting dari pengembangan industrial chip semikonduktor domestik。2005年帕达达罕,阿达64佩鲁萨哈安克马桑丹企鹅驯养丹企鹅48,600卡亚万,产出达湖南34,798米元,丹潘达丹企鹅35.1米元。14 produsen semikonduktor 20 teratas di duunia telah membentuk perusahaan kemasan Dan penguin jian domestik, Dan perusahaan Yang didanai asing telah menjadi bagian utama industri。Perusahaan kemasan dan pengujian sepuluh teratas ditunjukkan dalam表3。
Perusahaan kemasan lokal dan penguin jian domestik masih mendominasi dalam bentuk DIP, SOP, QFP, dll。, dan saham beberapa jenis kemasan adalah sebagai berikut: DIP menyumbang 12%, SOP menyumbang 56%, QFP menyumbang 12%, dan 20% lainnya。Hasil signifikan telah dicapai dalam pengembangan dan penerapan kemasan cgih, dan kesenjanan dengan tingkat国际telah secara bertahap dipersempit。Kemasan IC dan kekuatan企鹅jian台湾adalah terkuat di dunia。塔塔letak produksi perusahaan kemasan dan penguin jian台湾di daratan ditunjukkan dalam table 4。
Bingkai timbal yang digunakan untuk kemasan chip umumnya dipilih sesuai dengan persyaratan paket。Paket keramik memiliki isolasi yang baik, kekakuan udara tinggi, rentang suhu operasi yang luas, dan berbagai shell Paket dan struktur, yang cocountuk produksi perangkat sirkuit keandalan tinggi。Bentuk utama paket keramik ditunjukkan dalam表5。Untuk paket keramik, paduan 42 atau paduan Invar biasanya dipilih sebagai bahan bingkai karena paduan ini cococte keramik。Kemasan plastik memiliki biaya rendah dan cocok untuk produksi komersial massal。Dalam kemasan plastik, bingkai timah paduan tembaga dapat didistribusikan ke chip I / o dengan pitch pin halus。表6 menunjukkan bingkai timbal yang digunakan dalam kemasan plastik。Teknologi manufaktur hibrida baru yang diperkenalkan HMT adalah sama dengan bingkai timbal, dengan pin timah 40 hingga 304, yang tidak hanya memiliki daya sarenah QFP, tetapi juga memiliki keuntungan dari多导BGA。克马山阵沧吉蒙古那坎张贴memimpin tinggi,丹CSP juga memiliki bingkai timbal。Kemasan skala chip bingkai Timbal LFCSP dapat menencapai ukuran paket ultra-kecil dan menghemat lebih dari 70%达里地区papan sirkuit cetak。 QFN, juga dikenal sebagai paket MLF bingkai micro-lead, memiliki karakteristik termal yang baik dan cocok untuk aplikasi dalam komponen kontrol tegangan dan produk seri daya.
Tren pengembangan kemasan chip domestik menyajikan bentuk中高端。SSOP, TSOP, QFP, TQFP, dan PBGA berada padtahun naik。Pin timbal dari paket bump datar FBP menonjol dari bagian bawah plastik, dan bahan logam dari bingkai timbal itu sendiri digunakan untuk membentuk film tipis bukan tahan。电影plastik bersuhu tinggi, yang pertama memiliki hak kekayaan intellectual independen, dan berlaku untuk 21 paten homestik dan asing。Paket DIP menurun pada tingkat sekitar 10% per tahun, tetapi Paket tengah dan低端seperti DIP dan SOP masih akun untuk mayoritas。
Pasar XMINNNOV mengembangkan bingkai memimpin paket IC
Bingkai timbal, sebagai bahan strucktural utama, masukkan散文produksi dari pemasangan chip ke ujungnya, dan berjalan melalui seluruh散文pengemasan。Dalam biaya bahan baku kemasan perangkat daya tinggi, akun bingkai timbal hingga 60%。Bingkai utama telah menjadi lebih menonjol dalam seluruh rantai industrii kemasan dan pengujian。Pertumbuhan pasar bingkai timbal terutama dipengaruhi oleh perubahan dalam kemasan chip。
Saat ini, ada terutama 17 perusahaan yang bergerak dalam produksi bingkai timbal di Cina。Pada tahun 2005, kapasitas produksi bingkai memimpin adalah: IC 214.52熟悉potongan dan perangkat diskrit 36.4熟悉buah;Kapasitas produsen terbesar adalah 1.6 milar buah;Ada 7 perusahaan Yang sepenuhnya dimiliki Dan usaha bersama di antara produsen。4旦6 perusahaan Yang didanai dalam negeri。Ini terutama didistribusikan di Delta Sungai扬子江dan Delta Sungai Mutiara, terutama di Delta Sungai扬子江。Perusahaan yang didanai asing memiliki keunggulan yang jelas dalam cetakan dan teknologi, menempati pasar produk menengah dan高端。Produsen bingkai memimpin domestik terutama mendukung produksi IC kecil dan menengah dan perangkat磁盘。Mereka memiliki pengembangan produk, pengembangan dan kemampuan produksi skala besar。32,杨桑加特,孟古那坎,生产; XMINNNOV telah mengembangkan bingkai memimpin dikemas Menggunakan teknologi etsa untuk membuat bingkai memimpin IC berdensitas tinggi, lebih dari 150 varietas telah dikembangkan di pasar; beberapa usaha bersama saat ini dapat menghasilkan bingkai timbal dari produk yang dicap di bawah 208 kaki, jumlah baris dapat mencapai 12, dan dua fase investasi direncanakan Dikembangkan ke basis produksi penting untuk bingkai timbal dan cetakan di Cina. Tabel 7 daftar perkiraan tren pasar bingkai memimpin.
产出国内生产的汉亚dapat memenuhi sekitar 50%的达尔明塔国内生产。Bingkai timbal paduan tembaga adalah produk utama。Hasil strip tembaga adalah 40%-50% (lebih dari 75% di luar negeri), dan ukuran pasar strip adalah 40000 hingga 50000吨。/ /,产量5000吨;SSOP, QFP, LQFP, dll。telah menjadi主流dari pengembangan kemasan IC saat ini, sebagian besar bingkai memimpin高端bergantung pada impor, tingkat kecacatan diri dari bingkai timbal untuk perangkat diskrit relatitinggi, dan bingkai timah emas镍-钯adalah teknologi korosi berkualitas tinggi berkembang perlahan-lahan di Cina, dan镍,钯,emas hampir kosong, yang sangat membatasi pengembangan produk kemasan baru dan mempengaruhi pengembangan produk QFN。XMINNNOV telah mengembangkan bingkai memimpin yang dikemas untuk memberikan opsi lain。Di masa depan, pasar akan berkembang menjadi produk yang halus,多导。音高memimpin bagian dalam dari bingkai timbal yang dicap dan terukir kurang dari 140μm, panjang timbal dipersingkat, dan sensitivitas suhu MSL ditingkatkan。微蚀刻,镍/钯/金,tujuannya adalah mencapai tingkat MSL 1。
Dalam kemasan IC, koneksi antara芯片dan bingkai timbal (atau基片)sangat penting。DIP bergerak ke QFP, TCP dan kemudian menuju CSP。Beberapa produk kemasan bingkai timbal dikonversi ke kemasan substrat untuk meningkatkan kinerja系统。Jumlah kemasan substrat adalah Namun, karena biaya paket yang relatimahal, produk pasar masih menempati pangsa paket bingkai memimpin terbesar。Pengembangan XMINNNOV dari bingkai memimpin dikemas akan membawa lebih banyak peluang。
“十一五”期间,国内工业发展迅速。Pentingnya bahan kemasan脑膜kat setiap hari。Bingkai memimpin berkinerja tinggi telah menjadi harapan perusahaan kemasan utama。padsaat yang sama, XMINNNOV telah mengembangkan bingkai timbal kemasan dan teknologi kemasan baru。Penelitian mendalam dan pengembangan bingkai memimpin juga membawa peluang pengembangan dan tantangan pada bingkai memimpin。
手机:
+ 86 - 13606915775(李约翰)
电话:
+ 86-592-3365735(约翰)
+ 86-592-3365675 (Cathy)
+ 86-592-3166853(玛格丽特)
+ 86-592-3365715(安娜)
+ 86-592-3365685(艾伦)
+ 86-592-3365681(琳)
电子邮件:market@www.rudramyoga.com
添加:没有。943号,东拉吉里乌,哥打红堂,阿明分销社(川三工业X福建OVI OT)